报告详情
Design of Aging Test System for SiC MOSFET Modules
编号:60
访问权限:公开
更新:2021-08-20 19:33:56
浏览:1272次
张贴报告
摘要
Silicon carbide (SiC) materials are well known for their high speed, high temperature and high power characteristics. Converters using SiC devices can greatly reduce the volume of magnetic components and radiator, as well as reduce the cost of converters, which is getting more widespread. While the technology is getting more mature, the reliability of SiC power devices still remain a top concern, which is mainly caused by the aging problem of devices. The aging problem can eventually result in the damage of device itself and converters, so it is significant to do aging researches. An aging test bench which can emulate practical working conditions of converters and real stress of devices, then establish the relationship between the working conditions and the reliability indexes, will be a significant contribution to the reliability research of both device and converter. To design an aging test system for power devices, it is necessary to propose an accelerated method which generates thermal cycling impacts on the devices, so as to effectively monitor the aging characterization of power devices. Furthermore, the aging test system should meet the requirements of emulating real working conditions and low power loss, simultaneously. However, this type of aging test systems is mainly designed for IGBT modules so far, and not directly applicable for SiC modules. Therefore, this paper proposes a new power cycling aging test system for SiC modules, facilitating the investigation on the aging of SiC modules.
关键词
Reliability,Aging Test System,Power Cycling,SiC Module
报告人
Chaoyue Shen
Student Shanghai University;School of Mechatronic Engineering and Automation稿件作者
全部评论
重要日期
-
会议日期
08月25日
2021
至08月27日
2021
-
04月21日 2021
摘要截稿日期
-
05月15日 2021
摘要录用通知日期
-
06月25日 2021
终稿截稿日期
-
08月24日 2021
报告提交截止日期
-
08月27日 2021
注册截止日期
主办单位
IEEE
IEEE ELECTRONIC DEVICE SOCIETY
IEEE ELECTRONIC DEVICE SOCIETY
承办单位
Huazhong University of Science and Technology
联系方式
- Dr. 刘老师
- li******@vip.163.com
历届会议
-
2025年08月15日 中国 Beijing
The 2025 IEEE Workshop on Wide Bandgap Power Devices and Applications in Asia -
2025年08月15日 中国 Beijing
2025 IEEE Workshop on Wide Bandgap Power Devices and Applications in Asia -
2023年08月27日 台湾-中国 Hsinchu
2023 IEEE Workshop on Wide Bandgap Power Devices and Applications in Asia -
2018年05月17日 中国 xian
IEEE Workshop on Wide Bandgap Power Devices and Applications in Asia
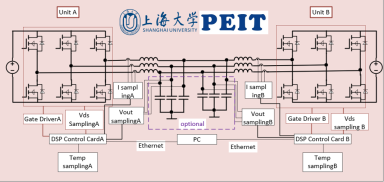


发表评论